
WAFER INSPECTION SERIES
Na-W320 全自动晶圆AOI量检测
2D+3D 双模并发检测技术,专为先进封装制程中的微米级缺陷捕获而设计。
Na-W320 AOI量检测系统
Wafer Appearance Optical Inspection System

系统概览 Overview
Na-W320 为半导体生产全流程提供晶圆表面 2D 检测与后制程凸点 3D 高度的测量分析工具,助力实现高效精准的品质管控。
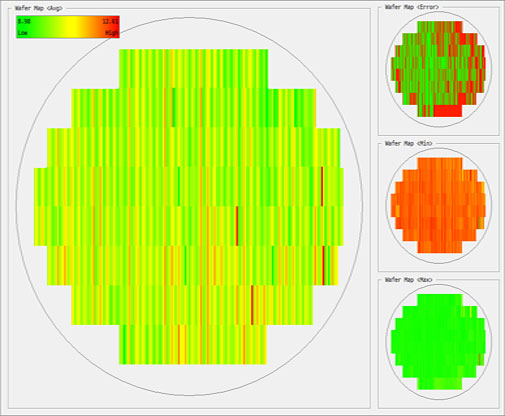
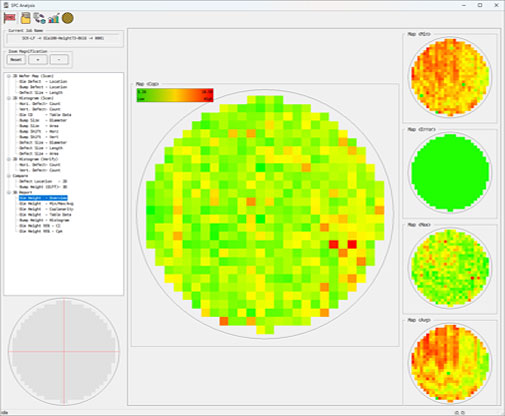


FEATURES 功能特性
2D & 3D 检测
彩色线扫描相机检测
采用彩色线扫描相机进行高精度颜色检测,精准识别色彩差异。
双照明系统
应用反射式与漫射式双照明技术,实现超快速成像转换。
基底颜色均一化算法
专有算法最小化基底结构的颜色变化,提升检测稳定性。
实时缺陷捕获
实时缺陷抓取技术,大幅提升生产效率和检测产能。
可检测基板类型
- 焊料凸点:球形凸点 (Ball)、铜柱 (Cu-Pillar)、C4、微凸点 (Micro Pillar)、重布线层 (RDL)、扇出型 (Fan-Out)
- 金凸点:Gold Bump
- EDS 测试:探针痕迹 (Probe Mark)、墨点 (Ink)
- 封装:PKG
检测应用领域
- 硅晶圆:6"、8"、12"
- 其他基材:玻璃、钢材、环框架、芯片托盘
- 面板级封装:PLP
SPECIFICATION 技术规格
2D & 3D 检测规格
晶圆尺寸
200 & 300 mm
凸点类型
Cu、Solder、Solder Ball、RDL、Gold、Nickel、Silver、Micro、C4 等
芯片尺寸范围
0.4 ~ 30 mm
处理类型
裸晶圆 (8 & 12 英寸)、环框架 (选配)
晶圆厚度
350 ~ 800 µm
图谱映射
Door Mapping
2D 测量
CD 测量 (焊料凸点尺寸违规检测)
3D 精度与重复性
≤ 1 µm (基于纳准标准块)
凸点高度范围
5 ~ 350 µm
检出率
≥ 95% (≥ 2 Pixel)
常见问题 FAQ
Na-W320支持哪些类型的凸点检测?
Na-W320支持多种凸点类型检测,包括:铜柱(Cu-Pillar)、球形凸点(Ball/Solder Ball)、C4凸点、金凸点(Gold Bump)、RDL重布线层、扇出型(Fan-Out)以及微凸点(Micro Pillar)等。
Na-W320的3D测量精度能达到多少?
Na-W320的3D精度与重复性≤1μm(基于纳准标准块),检出率≥95%(≥2 Pixel),凸点高度测量范围为5~350μm,满足先进封装制程的高精度量测要求。
Na-W320和普通AOI设备的核心差异是什么?
核心差异在于:①彩色线扫描相机+双照明系统的组合实现2D+3D双模并发检测;②基底颜色均一化算法专有技术提升检测稳定性;③RTG实时缺陷捕获技术大幅提升产能;④支持8英寸和12英寸晶圆全流程检测。
Na-W320是否支持非硅材质基板检测?
是的,除了6"/8"/12"硅晶圆外,Na-W320还支持玻璃基板、钢材基板、环框架(Ring Frame)、芯片托盘等多种基材检测,并支持面板级封装(PLP)应用场景。