
Na-80 双面对准度测量仪
非接触式机器视觉检测,实现亚微米级重复精度的晶圆正反面对位方案。
Na-80 双面对准度测量仪
Double-Sided Alignment Measurement System

产品设计综述 (OVERVIEW)
Na-80 是由安徽纳准半导体研发的专业级双面位置对准测量仪。该设备特别针对半导体先进制程中的晶圆正反面对位需求设计,采用非接触式机器视觉技术,确保在不产生任何物理损伤的前提下,提供亚微米级别的测量精度。
亚微米精度
重复精度达到 ±0.2μm (1σ),满足严苛的量测要求。
一键全自动
识别待测图案后,一键完成所有测量步骤,操作便捷高效。
300mm 兼容
最大支持 12 英寸 (300mm) 晶圆,并向下兼容 8 英寸及更小尺寸。
非接触测量
完全依靠图像识别,对透明及不透明材料均有良好的检测适配性。
核心技术优势
- 先进机构:采用比较测量方式,有效规避光路和机械错位带来的系统误差。
- 智能校准:专属一键式校准方案,自动消除放大倍率误差,确保数据一致性。
- 灵活配置:上下双光路显微系统,支持 5×, 10×, 20× 等多种倍率物镜可选。
- 软件合成:支持表面与背面图像的合成显示,直观呈现对位结果。
技术参数 (Na-80 Spec)
| 样品尺寸 | 8"/12" (向下兼容) |
| 样品厚度 | ≤ 10 mm |
| 测量精度 | ±0.2 μm (重复性) |
| 光学倍率 | 5× / 10× / 20× (可选) |
| 调焦方式 | 电动 / 自动聚焦 (可选) |
| XY 平台行程 | X: 150mm / Y: 20mm (电动) |
| 数据记录 | 图像及结果自动存储 |
测量原理与应用示例
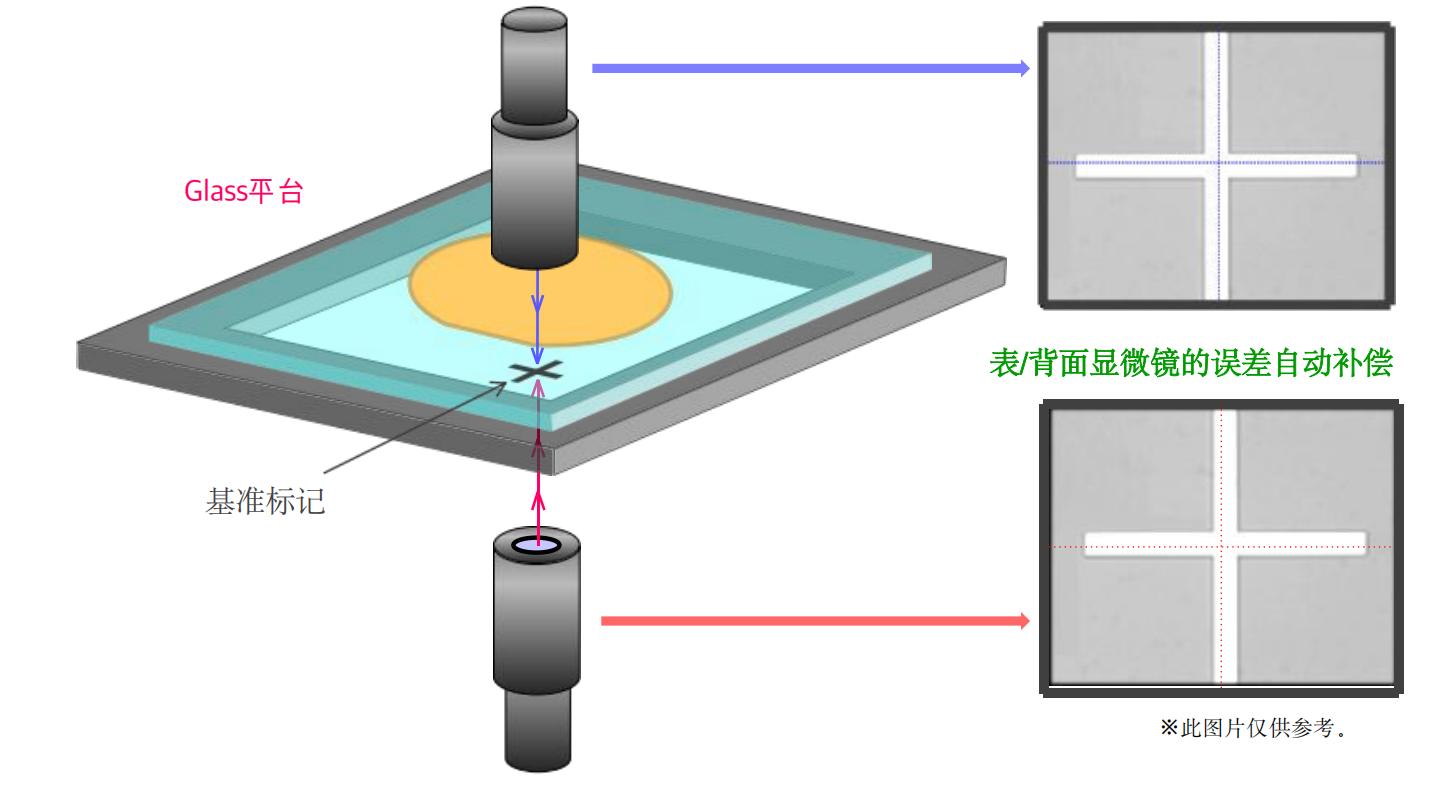
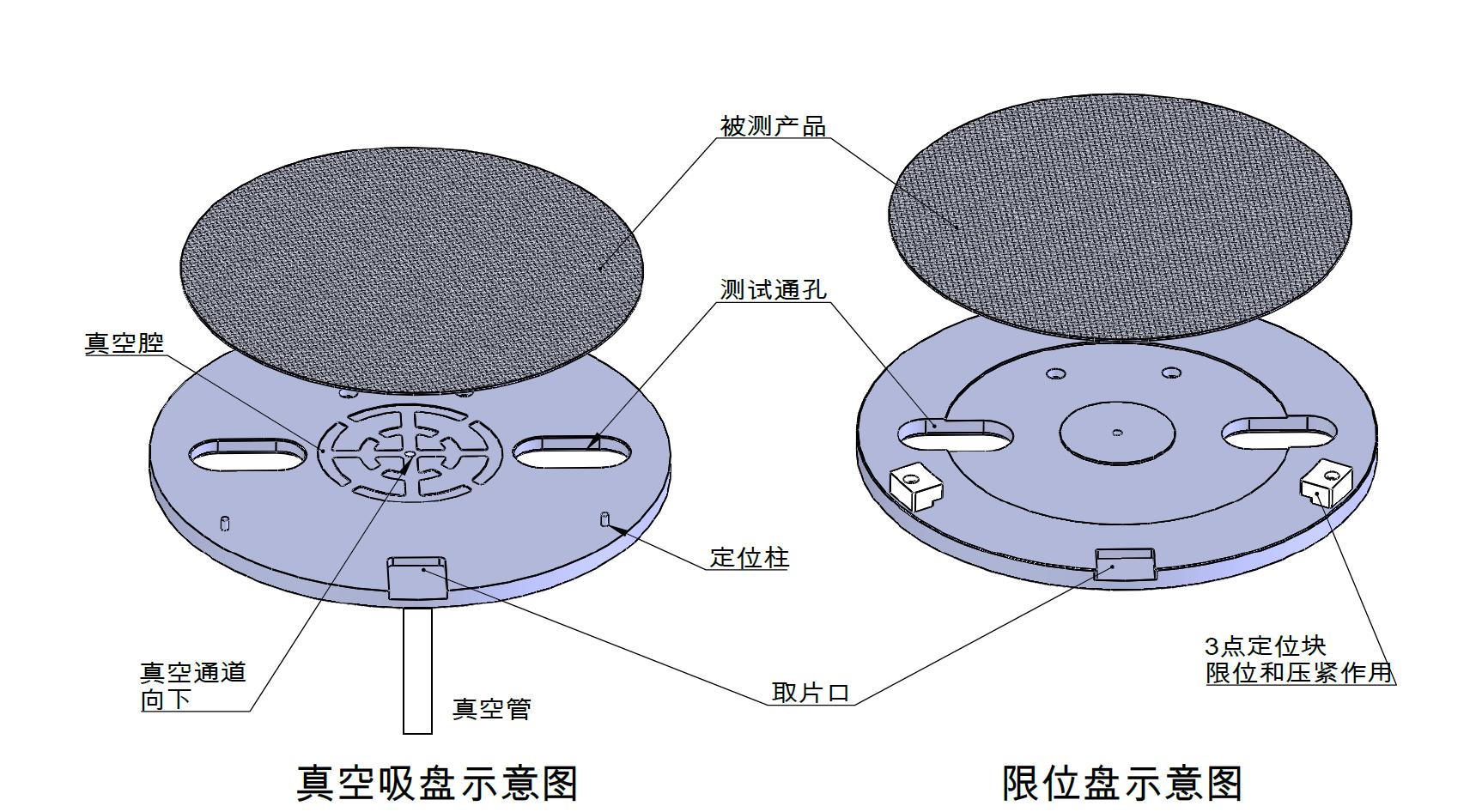
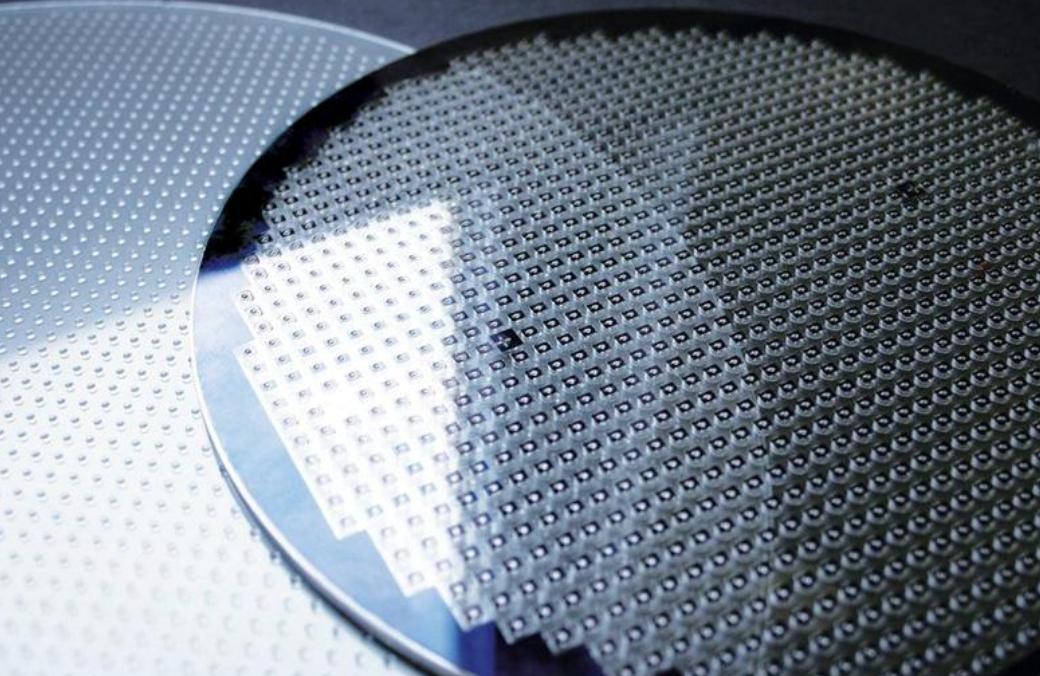
应用领域
广泛应用于 BAW 体声波滤波器、MLA 微透镜阵列、MEMS 微机电系统以及 WLO 晶圆级光学等精密对位场景。
系统架构
机架式紧凑结构设计,仅需单个工位即可完成全流程检测,大幅节省无尘室空间。
常见问题 FAQ
Na-80对准度测量的精度如何保证?
Na-80采用比较测量方式,有效规避光路和机械错位带来的系统误差。专属一键式校准方案自动消除放大倍率误差,确保数据一致性。实际测量精度达到±0.2μm(1σ重复性)。
Na-80支持多大的样品尺寸?
Na-80最大支持12英寸(300mm)晶圆样品,同时向下兼容8英寸及更小尺寸。样品厚度支持≤10mm,覆盖BAW体声波滤波器、MLA微透镜阵列、MEMS微机电系统和WLO晶圆级光学等精密对位场景。
非接触式测量相比接触式有什么优势?
完全依靠图像识别的非接触式测量不会对待测材料产生任何物理损伤,对透明和不透明材料均有良好的检测适配性。上下双光路显微系统支持5×、10×、20×多种倍率物镜可选,电动/自动聚焦可选配。